AI熱潮持續升溫,全球晶片產業正面臨新一波產能爭奪戰。隨著NVIDIA、AMD等AI晶片大廠,以及雲端服務業者積極投入自研ASIC晶片,先進製程與先進封裝需求快速成長,也讓台積電3奈米製程與CoWoS先進封裝產能出現明顯吃緊情況。
台積電日前在法說會中證實,目前3奈米需求相當強勁,產能確實緊張,並已積極擴建新廠、增加產能。市調機構集邦科技TrendForce預估,隨著AI運算晶片陸續轉進3奈米,全球3奈米產能將在2026年底超越5奈米與4奈米,並在2027年為僅次於28奈米第二大關鍵製程節點。
TrendForce指出,AI需求自2023年起快速成長,帶動3奈米、2奈米晶圓代工,以及2.5D、3D先進封裝需求同步上升。其中,CoWoS產能短缺問題最為嚴重,不只封裝產能不足,連相關設備、封裝載板、玻纖布、PCB、HBM記憶體、SSD等周邊材料與零組件,也都面臨供應壓力。
目前3奈米先進製程主要由台積電供應,Samsung與Intel在3奈米晶圓代工進度上仍落後台積電,加上許多晶片設計案早在一到三年前就已定案,因此短時間內難以轉換供應商,讓台積電成為全球科技大廠爭搶的關鍵產能來源。
在AI晶片需求快速增加下,NVIDIA因長期深耕供應鏈,較早掌握產能緊縮訊號,提前預訂大量4奈米、3奈米晶圓代工與CoWoS封裝產能,也同步鎖定HBM、PCB、封裝載板等重要資源。相較之下,部分科技大廠雖然AI需求同樣強勁,但因未及早掌握關鍵零組件供應,導致產品出貨與成長動能受到限制。
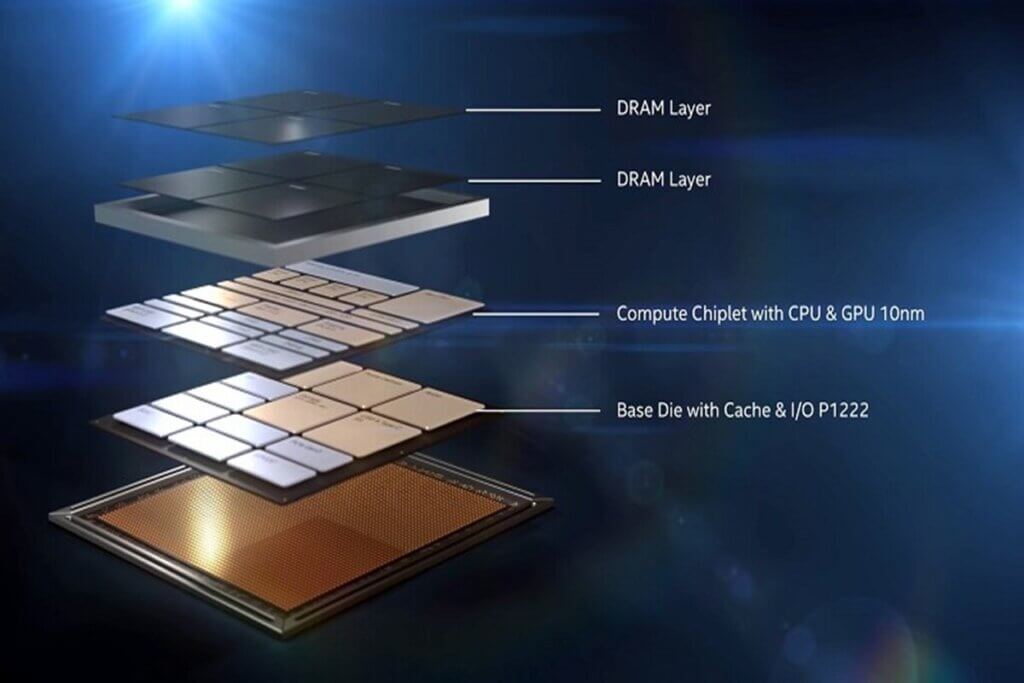
隨著AI晶片算力愈來愈高,單一晶片需要使用的晶圓面積、封裝面積與材料用量也大幅增加,讓整體供應鏈壓力持續升高。
即使台積電積極擴廠,CoWoS自2023年以來仍呈現供不應求,部分訂單也開始外溢至矽品、Amkor等封測廠,Intel的EMIB技術與矽品FOEB等類似封裝方案,也因此受到市場關注。
TrendForce預估,台積電規劃在2027年新增超過六成CoWoS產能,屆時全球2.5D封裝嚴重缺貨的情況可望略為改善。不過,在AI伺服器、雲端運算、高階處理器與各類AI應用持續擴張下,先進製程與先進封裝仍將是未來半導體產業競爭的核心。
整體來看,AI已不只是帶動晶片需求增加,更正在重新分配全球半導體供應鏈資源。從晶圓代工、先進封裝,到記憶體與關鍵材料,誰能先取得穩定產能,誰就能在AI競賽中取得更大優勢。