成熟製程供給偏緊、金凸塊與封測壓力升高,顯示供應鏈成本轉嫁效應浮現
在晶圓代工與封裝測試報價陸續走揚下,顯示驅動IC(Display Driver IC, DDIC)供應鏈正面臨新一波成本壓力。
由於上游晶圓代工與後段封測費用同步墊高,近期已有部分DDIC廠商開始與面板客戶溝通調漲報價可能性,顯示供應鏈成本轉嫁壓力已逐步浮現。
從DDIC成本結構觀察,晶圓代工約占整體成本六至七成,後段封裝與測試則約占兩成。換言之,只要晶圓代工與封測價格上升,DDIC廠商就很難完全自行吸收。尤其在原物料、能源、人力與貴金屬成本同步增加下,相關供應商的獲利空間正受到明顯壓縮。
8吋與12吋晶圓產能偏緊成本抬升
近期晶圓代工報價上升,主因之一在於8吋晶圓產能長期未大幅擴充,且又受到PMIC、Power Discrete等電源產品需求擠壓,使供應持續維持緊張。由於DDIC產品高度仰賴高壓製程,當8吋產能偏緊,高壓製程成本也隨之上升。
在12吋晶圓方面,部分台系代工廠近來減少高壓製程產能,使更多客戶將訂單轉向原本就承接DDIC業務晶圓廠,帶動相關產線利用率維持高檔,支撐成熟製程價格走升。
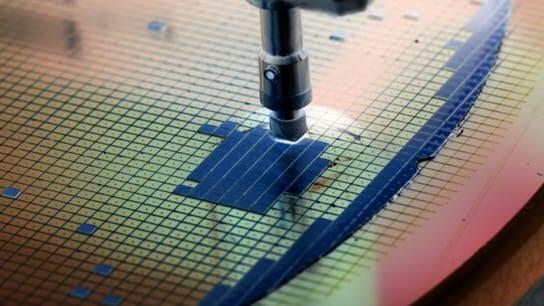
整體來看,不論是8吋,或與DDIC相關的部分12吋成熟製程,目前都呈現供給偏緊、成本抬升態勢,讓DDIC廠面臨更大的報價調整壓力。
除前段晶圓代工外,後段封裝與測試也同步承壓。DDIC產品需歷經金凸塊(bumping)、封裝、測試等多道製程,近期因封裝產能吃緊,加上材料與人工成本增加,封測代工價格有上調趨勢,以COF(Chip-on-Film)與COG(Chip-on-Glass)等產品線的壓力最為顯著。
黃金導入替代材料、卻也難抵成本壓力
值得注意的是,國際金價自2024以來維持高檔,進一步推升金凸塊材料成本。雖然部分業者逐步導入替代材料或其他製程方案,降低對黃金材料依賴,但短期內仍難完全抵消金價上升所帶來的成本壓力。
對DDIC供應商而言,若上游晶圓與封測漲勢延續,未來調升報價的可能性將進一步提高,而最終漲幅仍將取決於產品類型、終端應用、市場供需與客戶結構。
從終端應用來看,DDIC廣泛用於電視、監視器、筆記型電腦與智慧型手機等顯示產品,因此這波成本變動不僅影響IC設計與面板供應鏈,也可能逐步傳導至品牌廠與消費市場。若面板廠無法完全吸收上游成本,終端產品售價與整體通膨壓力都可能進一步受到影響。
AI需求擴張導向先進製程市場格局
另一方面,晶圓代工產業整體景氣在AI需求帶動下仍維持擴張。2025年全球晶圓代工產業已受惠於AI應用與供應鏈預防性備貨,產值突破2,000億美元;展望2026年,在AI相關主晶片、周邊IC與資料中心需求持續成長下,全球晶圓代工產業規模可望進一步上看2,500億美元。
在競爭格局方面,台積電憑藉先進製程與產能優勢,龍頭地位仍相對穩固;三星與英特爾則在晶圓代工第二名之爭中加速布局。
至於中國晶圓代工業者,除持續擴充成熟製程外,也正逐步推進至7奈米等先進製程領域,未來市場對中系業者的觀察焦點,將從成熟製程進一步延伸至先進製程競爭力。
TrendForce 預估,2026年全球晶圓代工產值可望年增24.8%,達2,188億美元,其中台積電產值增幅可達32%,為成長動能來源。
台積電5/4奈米及以下先進製程產能預估將滿載至年底,且訂單能見度已延伸至2027年,使先進製程價格維持上行趨勢。相較之下,成熟製程雖受AI電源產品支撐而有所回溫,但12吋28奈米以上成熟製程仍面臨擴產與消費性需求疲弱的雙重壓力,整體供需表現仍呈分化。

台灣方面,2026年台灣晶圓代工產業年營收可望突破1,700億美元,年增幅接近30%。即使AI帶動先進製程維持強勁成長,產業仍須面對國際關稅政策、記憶體價格上升,以及地緣政治風險等不確定因素。
這些變數都可能進一步影響成熟製程接單、消費性電子需求與整體半導體景氣。
Crosswise Intelligence|縱橫解析
這波DDIC漲價壓力,反映的不是單一零組件的價格調整,而是成熟製程、高壓製程、封測與材料成本同步上升後的連鎖效應。
對供應鏈而言,2026年將呈現明顯的「雙軌化」局面:一端是AI持續推升先進製程與先進封裝需求,帶動龍頭廠商維持高成長;另一端則是成熟製程市場在局部吃緊與整體需求分化之間尋求新平衡。
DDIC供應商此刻啟動與客戶的漲價協商,正是整體半導體供應鏈重新定價的前哨訊號。